
- Home
- 解决方案
- Kiru(切)·Kezuru(削)·Migaku(磨)特集
- DBG (Dicing Before Grinding)工艺
DBG (Dicing Before Grinding)工艺
在300mm晶片的薄型化需求日益扩大的市场背景下,为了能够同时满足「300mm」与「薄型化」的市场要求,如何减少在搬运过程中发生的晶片破损及切割加工时产生的背面崩裂现象,已经成为生产厂家需要面对的重要课题。为了适应这些市场需求,本公司成功开发了DBG工艺。
DBG工艺
DBG就是将原来的「背面研削 →
切割晶片」的工艺程序进行逆向操作,先对晶片进行半切割加工,然后通过背面研削使晶片分割成芯片的技术。通过运用该技术,可更大限度地抑制分割芯片时产生的背面崩裂及晶片破损,从而能够顺利地从大尺寸的晶片上切割出芯片。
由于大幅度地减少了晶片的背面崩裂现象,所以能够在维持高抗折强度的同时,对晶片实施超薄加工,从而能够生产出高强度的芯片。
另外,由于通过研削机的研削加工对芯片实施分离作业,所以可有效地避免薄型晶片在搬运过程中的破损风险。
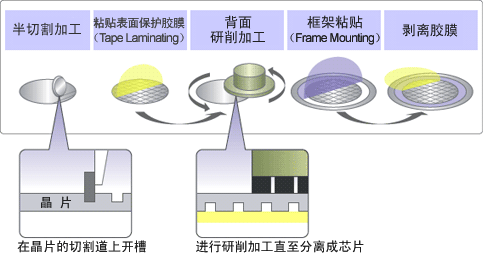
采用半切割用切割机对晶片表面的切割道(切割余量)实施开槽加工。在通常的切割加工中,会切割到晶片背面,直至完全切断。但是,在实施DBG工艺时,可以切割到所要求的芯片厚度尺寸为止。
完成半切割加工作业之后,先在晶片表面粘贴保护胶膜,再使用研削机进行背面研削加工。当研削到事先切入的切割槽时,晶片会被分割成一个个芯片(芯片分离)。然后将完成分割作业的晶片通过联机系统搬运到DBG框架粘贴机(Mounter)上,先实施位置校准作业,再粘贴到框架上,最后在剥离晶片的表面保护胶膜之后来完成整个工序。
加工対応装置
DBG工艺可更大限度地抑制因切割加工时产生的背面崩裂现象以及因搬运时产生的晶片破损,并能顺利地从大口径的晶片上分割出芯片。
在DBG工艺中,将使用以下设备。
- 半切割用切割机
- BG胶膜贴膜机(Laminator)
- DBG研削机
- DBG晶圆框架粘贴机(Mounter) (LINTIC株式会社制造)
- Personal Information Protection Policy
- Guarantee policy for customer using DISCO Products
- All rights reserved: DISCO Corporation.


